 搜 索
搜 索
 搜 索
搜 索
.jpg)
- 66 高校采購(gòu)信息
- 215 科技成果項(xiàng)目
- 2 創(chuàng)新創(chuàng)業(yè)項(xiàng)目
- 0 高校項(xiàng)目需求
三維非硅微納集成制造技術(shù)


項(xiàng)目成果/簡(jiǎn)介:
隨著支配半導(dǎo)體技術(shù)數(shù)十年的摩爾定律日益接近其發(fā)展極限,多種功能器件集成被認(rèn)為是超越摩爾定律延續(xù)集成電路發(fā)展進(jìn)程的重要途徑之一,這就需要能夠滿(mǎn)足多種功能器件高密度集成的制造技術(shù)。多元兼容集成制造技術(shù)就是為此而開(kāi)發(fā)的,該技術(shù)通過(guò)在更大范圍內(nèi)優(yōu)選結(jié)構(gòu)/功能材料組合,開(kāi)發(fā)異質(zhì)集成制造工藝,大大拓展了功能微器件創(chuàng)新設(shè)計(jì)和制造的騰挪空間。經(jīng)過(guò)多年探索,目前已形成了涵蓋金屬、聚合物、陶瓷、復(fù)合材料的MEMS異質(zhì)異構(gòu)制造技術(shù)體系,并在多種類(lèi)型功能器件研發(fā)中發(fā)揮了關(guān)鍵作用,初步展現(xiàn)了其基礎(chǔ)性支撐作用,相關(guān)技術(shù)獲得2016年度上海市技術(shù)發(fā)明一等獎(jiǎng)。
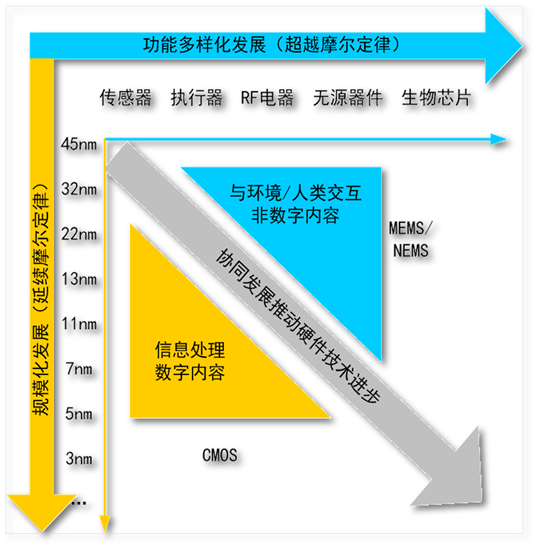
微系統(tǒng)集成發(fā)展趨勢(shì)
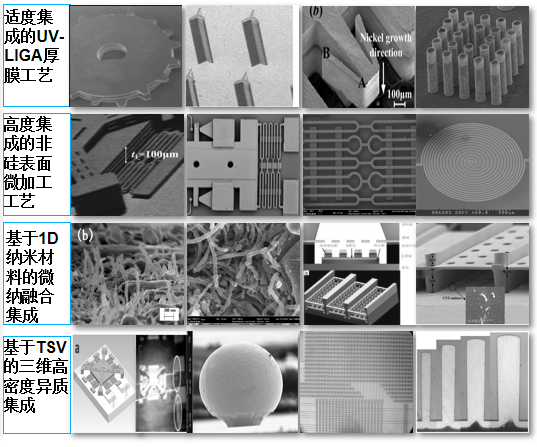
多元兼容集成制造技術(shù)
獲獎(jiǎng)情況
上海市技術(shù)發(fā)明一等獎(jiǎng)2016年團(tuán)隊(duì)獲獎(jiǎng)
國(guó)家技術(shù)發(fā)明二等獎(jiǎng)2008年
上海市技術(shù)發(fā)明一等獎(jiǎng)2007年

超薄超快高熱流密度微通道散熱器
上海交通大學(xué)團(tuán)隊(duì)在長(zhǎng)期研究經(jīng)驗(yàn)和技術(shù)積累基礎(chǔ)上,創(chuàng)造性地提出了不同高熱導(dǎo)率材料組合構(gòu)造的復(fù)合結(jié)構(gòu)微通道散熱器設(shè)計(jì)方案,并基于多元兼容集成制造技術(shù)完成了多種尺寸樣品研制,其中,熱源面積與常用功率芯片尺度相當(dāng)?shù)某∩崞骼鋮s能力達(dá)到800W/cm2以上,在保留傳統(tǒng)微通道散熱器良好系統(tǒng)兼容性和適用性的基礎(chǔ)上達(dá)到了相當(dāng)高的散熱能力水平,為解決高功率芯片系統(tǒng)超高熱流密度散熱問(wèn)題提供了一個(gè)深具可行性的解決方案。

高溫薄膜溫度傳感器研究
發(fā)動(dòng)機(jī)燃燒室等極端惡劣環(huán)境下(高溫、強(qiáng)振動(dòng)、強(qiáng)腐蝕等)的工作參數(shù)現(xiàn)場(chǎng)監(jiān)測(cè)對(duì)傳感器技術(shù)是嚴(yán)峻挑戰(zhàn),國(guó)內(nèi)外研究廣泛。交大團(tuán)隊(duì)基于特種材料微納集成制造技術(shù)的長(zhǎng)期積累,在高溫絕緣薄膜材料、多層薄膜應(yīng)力調(diào)控、曲面圖形化和高溫敏感介質(zhì)等技術(shù)上取得了一定突破,成功開(kāi)發(fā)了多種可與現(xiàn)場(chǎng)結(jié)構(gòu)共型的高溫薄膜傳感器,具有體積小、環(huán)境擾動(dòng)小、響應(yīng)快、靈敏度高、可分布式安置等優(yōu)點(diǎn),該團(tuán)隊(duì)已經(jīng)掌握了溫度、應(yīng)力/應(yīng)變、熱流等多種高溫狀態(tài)參數(shù)測(cè)量技術(shù),適用溫度在800-1300℃之間。

薄膜絕緣電阻隨溫度的變化及測(cè)試結(jié)構(gòu)
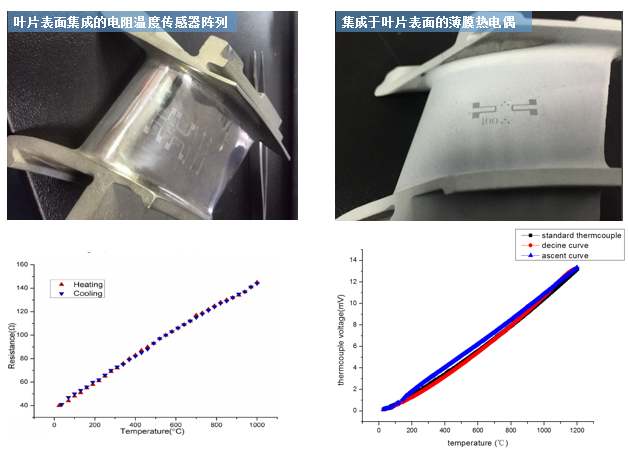
高溫薄膜溫度傳感器制造及曲面圖形化技術(shù)
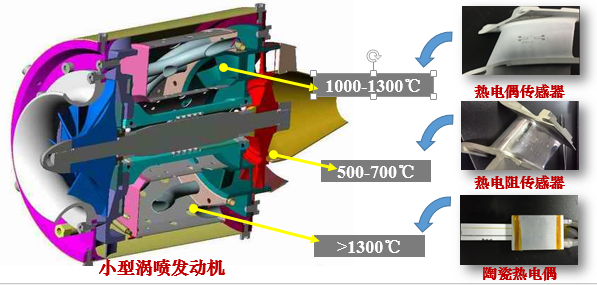
薄膜溫度傳感器在發(fā)動(dòng)機(jī)不同部位測(cè)溫需求

無(wú)線(xiàn)溫度傳感器測(cè)溫系統(tǒng)
高性能轉(zhuǎn)接板
基于轉(zhuǎn)接板的多芯片封裝是2.5D高密度集成最具可行性的方案之一。但是傳統(tǒng)的硅轉(zhuǎn)接板性?xún)r(jià)比不高,阻礙了廣泛應(yīng)用。上海交大團(tuán)隊(duì)基于非硅微加工技術(shù)的長(zhǎng)期積累,突破了硅轉(zhuǎn)接板絕緣層完整性和再分布層熱隔離的難題,成功研制了漏電流極低的低成本高性能硅轉(zhuǎn)接板。此外,還開(kāi)發(fā)了復(fù)合材料非硅轉(zhuǎn)接板,TCV陶瓷轉(zhuǎn)接板,TGV玻璃轉(zhuǎn)接板等各種三維封裝基板,實(shí)驗(yàn)室能夠針對(duì)不同類(lèi)型器件三維高密度封裝的具體要求,定制開(kāi)發(fā)不同功能的專(zhuān)用轉(zhuǎn)接板,為多功能、高密度、高功率、低成本封裝提供個(gè)性化解決方案。
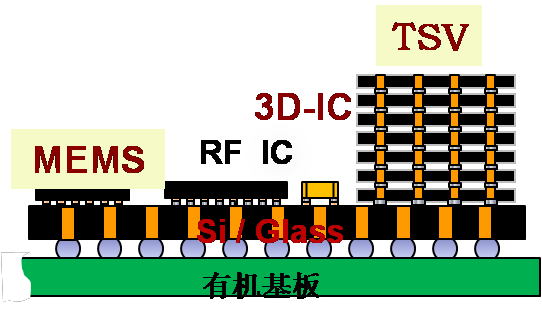
TSV-3D 高密度封裝概念圖
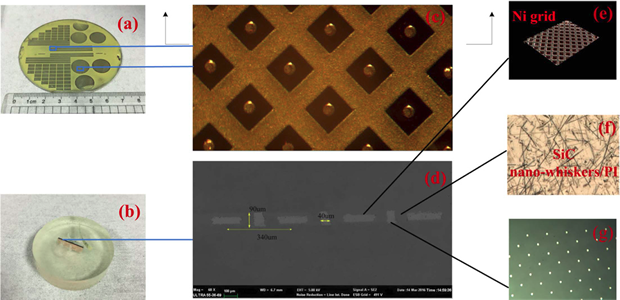
金屬-聚合物-納米復(fù)合材料非硅基轉(zhuǎn)接板實(shí)物圖片
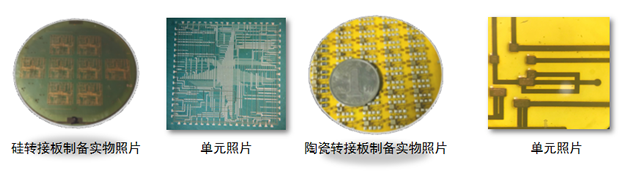
知識(shí)產(chǎn)權(quán)類(lèi)型:
發(fā)明專(zhuān)利 、 軟件著作權(quán) 、 集成電路布圖設(shè)計(jì)
技術(shù)先進(jìn)程度:
達(dá)到國(guó)內(nèi)領(lǐng)先水平
成果獲得方式:
獨(dú)立研究
獲得政府支持情況:
國(guó)家級(jí)

掃碼關(guān)注,查看更多科技成果





